|
1. Введение
Синие светодиоды на основе InGaN являются перспективными элементами приборов твердотельного освещения. По сравнению с лампами накаливания светодиоды способны обеспечить более высокий квантовый выход и долговременную стабильность [1]. Однако процессы деградации продолжают оставаться важной проблемой для светодиодов.
Проведенное в работах [2-4] исследование процесса деградации синих светодиодов фирмы Nichia, ускоренной сильноточным импульсным режимом при токах до 1500мА, выявило нестабильное и частично обратимое поведение тока и оптической мощности перед катастрофической деградацией. В частности, наблюдалось возникновение омических закороток, которые частично могли „самозалечиваться“ изменением полярности приложенного напряжения и вновь создаваться под прямым смещением [2]. Основными процессами, ответственными за катастрофическую деградацию светодиодов на основе GaN, считаются электромиграция металла из контактов вдоль дефектных трубок [2-4] и генерация дефектов [2-6].
В данной работе изучалась начальная стадия деградации светодиодов с гетероструктурой p-GaN/InGaN/n-GaN. Для этого во избежание перегрева через светодиод пропускались короткие токовые импульсы (0.1 -10 мкс) небольшой амплитуды (до 50 мА).
2. Эксперимент
Исследовались синие светодиоды с InGaN/GaN- квантовой ямой шириной 30 A˚, рабочим током 20 мА и площадью гетероструктуры S = 6 · 10-4 см2. Детали структуры светодиода приведены в работах [7,8].
Для исследования начальной стадии деградации через светодиод в течение нескольких часов пропускались токовые импульсы амплитудой Ip = 40-50 мА и длительностью tp = 0.1-10 мкс при частоте повторения 1кГц. Деградация светодиода проявлялась в уменьшении оптической мощности (до 50% от ее величины в рабочем светодиоде) и изменении электрических характеристик, а также в появлении временной задержки в распределении свечения по площади светодиодной структуры.
Распределение интенсивности электролюминесценции (ЭЛ) по площади светодиодов или неупакованных чипов изучалось с помощью цифровых микрофотографий. Для получения ЭЛ-изображений светодиодов эпоксидный упаковочный колпачок срезался, не нарушая герметичности упаковки, со стороны контактов или подложки параллельно плоскости гетероструктуры, затем плоскость среза оптически полировалась. Были также получены микрофотографии распределения интенсивности ЭЛ по площади коммерческих светодиодов фирмы Nichia. Вольт-яркостные (L-V) характеристики светодиодов измерялись с помощью Si-фотодиода.
2.1. Нестабильность и гистерезис I−V -характеристик после частичной деградации
На рис. 1, a приведены статические и импульсные I-V-характеристики светодиода до и после частичной деградации оптической мощности.
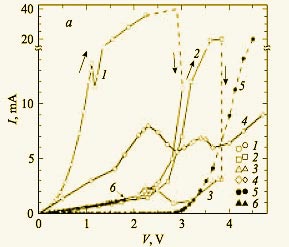 
Рис. 1. a — I-V-характеристики светодиода после (1–4) и до (5, 6) частичной деградации оптической мощности, измеренные в статическом (1–3, 5) и импульсном (4, 6) режиме. Длительность импульса tp = 100 мкс, время задержки для 4 — 50 нс. b — зависимости d log I/dV от напряжения для статического (1) и активного тока на частоте 1 МГц (2), измеренные в рабочем светодиоде.
Гистерезис и нестабильность статических I- V-характеристик при их последовательном измерении после деградации иллюстрируются кривыми 1-3. При первоначальном увеличении напряжения со скоростью 1 В/с наблюдался рост тока до величины I=10-30 мА при V = 2.2-2.8 В (кривая 1). Эмиссия света отсутствовала, вплоть до V < 3 В. При V ≈ 3 В ток резко уменьшался и одновременно вспыхивала электролюминесценция. При уменьшении напряжения до 2.3 В наблюдался гистерезис I -V-харак-теристики, а при последующем изменении напряжения в области ~ 2.3-2.9 В наблюдалось обратимое поведение I-V- и L- V- характеристик. После уменьшения напряжения до нуля и при последующем втором сканировании напряжения (кривая 2) появление электролюминесценции и уменьшение тока утечки наблюдалось при V«3.8В. Следующее сканирование напряжения (кривая 3) обнаружило дальнейшее уменьшение тока утечки, но электролюминесценция вновь появлялась только при V ≈ 3.8 В. В течение последующих сканирований поведение I -V и L-V-характеристик оставалось стабильным.
После выключения напряжения на несколько минут или часов часто наблюдалось отсутствие тока вплоть до V = 3.5-10 В, затем светодиод внезапно вспыхивал (ток ограничивался сопротивлением 100 Ом), после чего наблюдалось стабильное свечение и I-V-характеристики, близкие к представленной на кривой 3. Однако иногда светодиод вновь демонстировал I-V-характеристику, подобную представленной кривой 1.. В импульсном режиме после частичной деградации светодиод работал стабильно (кривая 4).
2.2. Временная задержка в распределении интенсивности ЭЛ по площади после деградации
ЭЛ-изображения светодиодов в импульсном режиме до и после частичной деградации иллюстрируют неоднородность свечения по площади (рис. 2, b–i). Все ЭЛ-изображения получены при одной скважности T/tp (T — период импульса), чтобы средняя мощность была одинакова. Полученные ЭЛ-изображения показывают, что после частичной деградации в светодиодах возникает задержка в распределении интенсивности ЭЛ по площади.
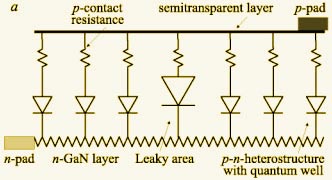 
Рис. 2. a — схема светодиода, иллюстрирующая латеральное протекание тока. b–i — ЭЛ-изображения светодиода после (b–e, h–i) и до (f, g) деградации, полученные в импульсном (b–g) и статическом (h–i) режимах. tp, нс: b — 22, c, f— 24, d — 26, e, g, i — 44, h — 70. V, V: f, g — 3; b–e, h — 3.7, i — 4.7. Скважность, T/tp: b–g, i — 50, h — 14.
В режиме коротких импульсов напряжения при tp = 20-30нс эмиссия света концентрируется вблизи полосковых краев p-контактной площадки (рис. 2, b, c). В светодиодах до деградации ЭЛ-изображения в режиме коротких импульсов более однородны (рис. 2, f, g). При длительностях импульсов 50 нс-1мс ЭЛ-изображения диода после деградации обнаруживают дефектные участки, вокруг p--контакта наблюдается более слабая интенсивность света (рис. 2, h–i).
На рис. 3 и 4 представлены ЭЛ-изображения и распределение интенсивности ЭЛ в области между n-- и p-контактами рабочих исследуемых светодиодов и свето-диодов фирмы Nichia. Из рисунков видно, что при малых токах (I < 100 мкА) в области p-контактов наблюдается более интенсивная ЭЛ, при больших токах — менее интенсивная.
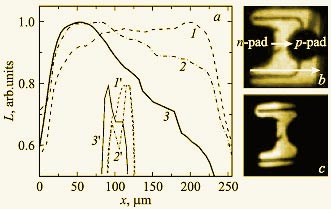 |
Рис. 3. а — нормированное распределение интенсивности ЭЛ в рабочем светодиоде вдоль слоя p-GaN по направлениям, указанным стрелками в (b). I, мА: 1,1' — 0.11, 2,2' — 20, 3,3' — 150. b, c — ЭЛ-изображения светодиода со стороны полупрозрачного слоя. I, мА: b — 0.11, с — 150. |
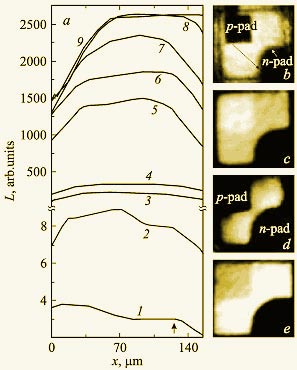 |
Рис. 4. a — распределение интенсивности ЭЛ в рабочем светодиоде фирмы Nichia между p- и n-контактами вдоль направления, указанного стрелкой в (b). Стрелкой отмечено положение края полупрозрачного слоя. I, мА: 1 — 0.018, 2— 0.16, 3 — 1.1, 4 — 2, 5 — 12, 6 — 20, 7 — 46, 8 — 100, 9 — 200. b-e —ЭЛ-изображения светодиода фирмы Nichia, полученные со стороны полупрозрачного слоя (b, d) и сапфира (c, e). I, мА: b — 0.018, c — 0.043, d — 46, e — 10. |
3. Обсуждение результатов
3.1. Влияние врожденных и индуцированных электрическим стрессом состояний гетерограниц на избыточные токи
Токи рабочего светодиода при напряжениях, меньших напряжения „включения“ VEL (в рабочем светодиоде VEL ≈ 2.4 В), имеют переходную и стационарную компоненты [7,8]. Переходной ток в импульсном режиме и активный высокочастотный ток могут на несколько порядков превышать стационарный (рис. 1, a, , кривые 5, 6). Индуцированные электрическим стрессом токи утечки значительно превышают переходные токи рабочего светодиода. Однако омические закоротки, возникающие после сильноточного электрического стресса [2–4], не наблюдались. Можно отметить корреляцию в зависимостях ток-напряжение до и после деградации. В частности, в области одних и тех же напряжений наблюдаются максимумы на кривых d log I/dV (V), измеренных до деградации (рис. 1, b), и на кривых I(V) после деградации (рис. 1, a, кривая 4).
Непротиворечивое объяснение этим фактам может быть дано в рамках туннельно-рекомбинационной модели избыточного тока p-GaN/InGaN/n-GaN-гетероструктур, не дающего вклада в электролюминесценцию [8]. Модель учитывает присутствие отрицательно заряженных акцепторных состояний на гетерограницах InGaN/GaN, пиннингующих уровень Ферми (рис. 5). Переходной ток при малых напряжениях V < VEL обусловлен туннелированием электронов из зоны проводимости n-GaN на состояния гетерограниц. Стационарный избыточный ток определяется рекомбинацией на гетерограницах. Туннельный ток электронов увеличивается с ростом плотности состояний с энергией, соответствующей энергетическому положению дна зоны проводимости в n-GaN. В рамках этой модели особенности зависимостей постоянного и импульсного прямого тока от напряжения, измеренных до и после деградации соответственно, отражают распределение граничных состояний в запрещенной зоне. Корреляция этих зависимостей позволяет сделать вывод, что дефекты на гетерограницах, генерируемые при деградации, характеризуются теми же уровнями энергии, что и до деградации. Отметим, что этот же вывод сделан ранее в работе [9] на основании наблюдавшейся корреляции температурных зависимостей емкости светодиода, измеренных до и после деградации [7,9].
 Рис. 5. Профиль энергетических зон p-n-гетероструктуры светодиода с InGaN/GaN-квантовой ямой до деградации (сплошные линии) и его изменение после деградации в участках, шунтирующих p-n-гетероструктуру (пунктирные линии). Рис. 5. Профиль энергетических зон p-n-гетероструктуры светодиода с InGaN/GaN-квантовой ямой до деградации (сплошные линии) и его изменение после деградации в участках, шунтирующих p-n-гетероструктуру (пунктирные линии).
Рост сквозного тока утечки при V < VEL в процессе деградации может быть связан с формированием электрического диполя в области гетерограниц InGaN/GaN. При этом встроенное напряжение р-n-гетероструктуры (Vbi) уменьшается на величину потенциала диполя (Vdip ), так что Vbi = ∆EF/q - Vdip (q — заряд электрона, ∆EF — разность равновесных уровней Ферми в слоях n-GaN и p-GaN). В результате локальные потенциальные барьеры в слоях n-GaN и p-GaN снижаются. В участках, шунтирующих p-n-гетероструктуру, барьерная структура светодиода может быть представлена в виде двух поверхностно-барьерных переходов с небольшими барьерами Шоттки (рис. 5). Латеральный конфайнмент канала утечки должен приводить к сильной зависимости тока канала от высоты барьеров и ширины областей объемного заряда в участках гетероструктуры, примыкающих к каналу. При этом нестабильность тока канала утечки (рис. 1,a, кривые 1-3) может быть связана с перезарядкой граничных состояний в участках, играющих роль „затвора“ канала.
3.2. Влияние дизайна р—и-гетероструктуры на однородность свечения по площади рабочих светодиодов в стационарном режиме
Полученные ЭЛ-изображения свидетельствуют о латеральной неоднородности инжекции носителей заряда в квантовую яму до и после деградации. Для выяснения механизма деградации необходимо рассмотреть причины неоднородности инжекции в рабочем светодиоде. Светодиоды на основе GaN выращены на изолирующей сапфировой подложке и инжекционный ток в них протекает латерально от p-контактной площадки через распределенное слоевое сопротивление полупрозрачного слоя NiO/Au, р-n-гетероструктуру с активной областью и p-контактным сопротивлением, распределенное слоевое сопротивление n--GaN к n-контактной площадке. Латеральное протекание тока иллюстрирует рис. 2, a, где р-n-гетероструктура представлена в виде серии микродиодов.
3.2.1. Малые токи, RJ >> rc,rn,rt_l
Сопротивление рабочего светодиода постоянному току велико при малых токах (при /=10мкА составляет 30кОм) и падает с ростом тока, становясь меньше 100 Ом при I > 2мА. При контактном сопротивлении слоя p-GaN rс ≈ 1-10Ом (rc=ρc/S, где ρс ≈ 5 · 10-3- 5 · 10-2 Ом·см2 — удельное контактное сопротивление слоя p-GaN), слоевых сопротивлениях слоя n-GaN и полупрозрачного слоя: rп≈ 50 Ом и rt_l ≈ 12 Ом соответственно, и I << 1 мА имеем rc,rn,rt_l,<<RJ , RJ— внутреннее сопротивление гетероструктуры p-GaN/InGaN/n-GaN. При этом распределения тока и интенсивности ЭЛ по площади должны отражать неоднородность локального внутреннего сопротивления гетероструктуры.
При малых токах наибольшая интенсивность ЭЛ обнаруживается вокруг p-контакта в рабочих исследуемых светодиодах (рис. 3, b), а также вокруг и под p-контактом в светодиодах фирмы Nichia (рис. 4, b, c). Распределения интенсивности ЭЛ между p- и n-контактами, приведенные на рис. 3-4, также демонстрируют более интенсивную ЭЛ вблизи p-контакта при малых токах.
3.2.2. Большие токи, RJ << rc, rn, rt_l
При rt_l << rn плотность тока уменьшается с расстоянием от края n--контакта. В одномерном приближении характеристическая длина растекания тока, Ls, на которой плотность тока уменьшается в е раз, может быть записана в виде [10]: Ls = (ρc/rn)1/2. При ρс ≈ 5 · 10-3-5 · 10-2 Ом·см2 и rn ≈ 50 Ом получим в качестве оценки Ls ≈ 100-300мкм. Как видно из рис. 3-4, при больших токах вблизи n-контактных площадок наблюдается более яркая ЭЛ. Однако по мере удаления от n-контакта интенсивность ЭЛ спадает немонотонно. Области вблизи p-контакта, более яркие при малых токах, становятся менее яркими при больших токах (рис. 3, c и рис. 4, d-e). При I > 20 мА интенсивность света вблизи p-контакта насыщается (рис. 4, кривые 6-9).
В рамках туннельно-рекомбинационной модели изменение относительной яркости с током объясняется присутствием отрицательного заряда состояний гетеро-границы, Q_> [8]. При малых напряжениях это приводит к более быстрому росту инжекционного тока в участках с повышенной плотностью отрицательного заряда и соответственно более яркому свечению. Но с увеличением напряжения пиннинг уровня Ферми приводит к подавлению инжекции и относительная яркость уменьшается.
Подтверждением вывода о том, что насыщение интенсивности ЭЛ вблизи p-контакта с током не связано с растеканием тока по слою n-GaN, является более слабая ЭЛ в области наименьшего расстояния между угловыми n- и p-контактами в светодиодах фирмы Nichia (рис. 4, d). Более слабая интенсивность ЭЛ в этой области при рабочих токах была ранее отмечена в работе [11], однако не было предложено объяснений этим наблюдениям.
Отметим, что в работе [12] в InGaN-светодиодах при больших токах наблюдался голубой сдвиг спектра ЭЛ вокруг p-контакта, что связывалось авторами с эффектами механических напряжений, вызванными металлизацией p-контакта. В то же время голубой сдвиг спектра ЭЛ обычно наблюдается в InGaN-светодиодах при увеличении плотности тока. Поведение локального свечения в области p-контакта при изменении тока дает основания полагать, что голубой сдвиг спектра ЭЛ может быть связан с влиянием заряда состояний гетерограницы InGaN/p--GaN в области p--контакта на локальную плотность тока.
При пиннинге уровня Ферми на гетерогранице понижение барьера в p-GaN с ростом напряжения составляет только малую долю внешнего напряжения. На эквивалентной схеме светодиода это может быть отображено заменой диода с сопротивлением RJ на „идеальный“ диод с сопротивлением REL, в котором ток безызлучательной рекомбинации на гетерогранице отсутствует, и последовательное сопротивление, равное RJ — REL. Характеристическая длина растекания тока при этом увеличится, для ее качественной оценки можно записать: Lt-r(U) = Ls [1 + ( RJ — REL)/ρc]1/2. Заметим, что в исследованных светодиодах наблюдалось выравнивание интенсивности ЭЛ при низких температурах (300 > Т > 77 K), когда туннельно-рекомбинационный ток доминирует уже при малых токах [8].
3.3. Распределение интенсивности ЭЛ по площади в импульсном режиме до и после деградации
Распределение интенсивности ЭЛ по площади гетероструктуры в импульсном режиме определяется переходным процессом в резистивно-емкостной цепи с распределенными параметрами (рис. 2). При приложении прямоугольного импульса напряжения в момент времени t = 0 напряжение на гетероструктуре на расстоянии, равном L, от краев n--контакта устанавливается за время: tL = (rnL2 + ρс)С, где С — удельная емкость.
Задержка в распределении яркости по площади после деградации может быть вызвана увеличением емкости светодиода при деградации, наблюдавшимся ранее при V < VEL [7,9]. Это подтверждает предположение о формировании электрического диполя на гетеро-границах структуры при деградации и соответственно уменьшении ширины обедненной области. Так как слой p-GaN легирован слабее (Na = 3 · 1017см-3), чем слой n--GaN (Nd = 1018см-3), увеличение емкости указывает на уменьшение потенциального барьера в слое p--GaN в процессе деградации.
На ЭЛ-изображениях деградировавшего светодиода, полученных в импульсном режиме, темный круг вокруг p-контакта виден уже при малых напряжениях. До деградации при малых напряжениях эта область была более яркой и более темной — при напряжениях, превышающих рабочие. Отсюда можно сделать вывод, что деградация, сопровождающаяся увеличением емкости, начинается вблизи p--контакта.
Выскажем некоторые общие соображения о влиянии утечки, шунтирующей р—n-гетероструктуру светодиода, на распределение ЭЛ по площади. Растекание тока утечки вызывает падение напряжения на n- и p-резистивных электродах, так что соседние участки оказываются под меньшим прямым напряжением и соответственно должны быть менее яркими, чем удаленные от дефектного участка. Можно получить простую оценку эффективной длины растекания тока локальной утечки Ll через участок гетероструктуры площадью Sl << S и внутренним сопротивлением rl < rt-r: Ll(V) = Ls[1 + (RJS — rlSl)/ρc]1/2. При росте прямого напряжения и уменьшении RJ воздействие шунтирующего диода должно эффективно экранироваться, и локализация утечки должна быть более четко видна в виде темных участков на ЭЛ-изображении, что и наблюдается в эксперименте (рис. 2, h-i).
3.4. Возможный механизм деградации
В работах [8,9] на основании анализа температурных зависимостей емкости и эффективности синих светодиодов сделан вывод о том, что пиннинг уровня Ферми на гетерограницах структуры p--GaN/InGaN/n--GaN связан с сегрегацией остаточных примесей — водорода и кислорода. Процесс деградации оптической мощности связывается с увеличением плотности состояний на гетерограницах и изменением их распределения в запрещенной зоне [9]. Корреляция особенностей I—V--характеристик светодиодов до и после деградации, наблюдавшаяся в данной работе, также позволяет сделать вывод, что дефекты, генерируемые в процессе деградации на гетерограницах, характеризуются теми же уровнями энергии, что и до деградации. Это служит указанием на то, что образование каналов утечек тока на начальной стадии деградации связано с электрической активностью остаточных примесей, а не с электромиграцией атомов металлов из контактов.
Влияние p--металлизации на I—V- и L—V-характеристики светодиода [13], а также на спектры ЭЛ под p-контактом [12] связывалось ранее с изменением p-контактного сопротивления, индуцированного процессами интердиффузии и межфазовых химических реакций [13], и механическими напряжениями в активной области [12]. Так, в работе [14] изменение сопротивления слоя p-GaN и p-контактного сопротивления при окислении бислоя Ni/Au связывалось с перераспределением профиля водорода. Планарная неоднородность ЭЛ-изображений, наблюдаемая в данной работе до и после деградации, говорит о влиянии p-металлизации на локальное внутреннее сопротивление гетероструктуры. Это влияние может быть вызвано диффузионными процессами и рождением электрически активных дефектов, индуцированных механическими напряжениями, создаваемыми p-металлизацией. Эти процессы могут приводить, например, к корреляции плотности пассивированных водородом оборванных связей с планарной неоднородностью контакта к слою p-GaN, обусловливая планарно-неоднородную инжекцию носителей заряда еще до деградации светодиода.
Дополнительная неоднородность инжекции и временная задержка свечения под p-контактом после деградации может быть вызвана появлением дополнительного отрицательного заряда на гетерогранице InGaN/p-GaN и формированием электрического диполя. Формирование диполя и деградация светодиода в участках под p-контактом может быть связана с электромиграцией водорода, а также трансформацией водородсодержащих комплексов на межфазных и межзеренных границах гетероструктуры, индуцированной захватом дырок. Это может приводить к образованию проводящих каналов, вероятнее всего, вдоль дефектных трубок, шунтирующих p-n-гетероструктуру светодиода.
4. Заключение
После деградации синих InGaN/GaN-светодиодов, ускоренной токовыми импульсами амплитудой до 50 мА, наблюдаются нестабильные утечки прямого тока. В режиме коротких (tp ≈ 20-40 нс) импульсов наблюдается задержка в распределении интенсивности ЭЛ по площади, а при увеличении длительности импульсов — темные участки вблизи p-контактных площадок. В рабочем светодиоде при малых постоянных токах (I < 100 мкА) эти участки светятся наиболее интенсивно, а при больших токах (I > 20 мА) — менее интенсивно. Изменение относительной яркости с напряжением в участках под p--контактом в рабочем светодиоде связывается с повышенной плотностью отрицательно заряженных акцепторных граничных состояний. Предполагается, что в процессе деградации увеличивается плотность состояний на гетерограницах InGaN/GaN и формируется электрический диполь. При формировании диполя потенциальные барьеры в n- - и p-слоях GaN снижаются, а емкость соответственно увеличивается. Это приводит к возрастанию токов утечки, а также к временной задержке растекания инжекционного тока и распределения интенсивности ЭЛ по площади в импульсном режиме. Планарная неоднородность инжекции носителей заряда в InGaN-квантовую яму до и после оптической деградации связывается с диффузией и электромиграцией водорода, индуцированной механическими напряжениями. Металлизация p-контакта может быть причиной генерации механических напряжений.
Н.И. Бочкарева, А.А. Ефремов, Ю.Т. Ребане, Р.И. Горбунов, А.В. Клочков, Ю.Г. Шретер
Физико-технический институт им. А.Ф. Иоффе Российской академии наук, 194021 Санкт-Петербург, Россия
Санкт-Петербургский государственный политехнический университет, 195251 Санкт-Петербург, Россия
Работа частично поддержана грантом Президента РФ НШ-2223.2003.2.
Список литературы
[1] S. Nakamura, G. Fasol. The Blue Laser Diode: GaN Based Light Emitters and Lasers (Springer, 1998).
[2] M. Osinski, J. Zeller, P.-C. Chiu, B.S. Phillips, D.L. Barton. Appl. Phys. Lett., 69, 898 (1996).
[3] M. Osinski, D.L. Barton, P. Perlin, J. Lee. J. Cryst. Growth, 189/190, 808 (1998).
[4] Introduction to Nitride Semiconductor Blue Laser and Ligth Emitting Diodes, eds. by S. Nakamura, S.F. Chichibu (London-N. Y.: Taylor & Francis, 2000).
[5] А.Н. Ковалев, Ф.И. Маняхин, В.Е. Кудряшов, А.Н. Туркин, А.Э. Юнович. ФТП, 33, 242 (1999).
[6] A.E. Yunovich, V.E. Kudryashov, S.S. Mamakin, A.N. Turkin, A.N. Kovalev, F.I. Manyakhin. MRS Int. J. Nitride Semicond. Res., 5S1, W11.25 (2000); nsr.mij.mrs.org /5S1/W11.25/.
[7] Y.T. Rebane, N.I. Bochkareva, V.E. Bougrov, D.V. Tarkhin, Y.G. Shreter, E.A. Girnov, S.I. Stepanov, W.N. Wang, P.T. Chang, P.J. Wang. Proc. SPIE, 4996, 113 (2003).
[8] Н.И. Бочкарева, E.A. Zhirnov, А.А. Ефремов, Ю.Т. Ребане, Р.И. Горбунов, Ю.Г. Шретер. ФТП, 39, 627 (2005).
[9] Н.И. Бочкарева, Е.А. Жирнов, А.А. Ефремов, Ю.Т. Ребане, Р.И. Горбунов, Ю.Г. Шретер. ФТП, 39, 829 (2005).
[10] X. Guo, E.F. Schubert. Appl. Phys. Lett., 78, 3337 (2001).
[11] P.Fischer, J. Christen, S. Nakamura. Jpn. J. Appl. Phys., 39, L129 (2000).
[12] P. Fischer, J. Christen, M. Zacharias, V. Schwegler, C. Kirchner, M. Kamp. Jpn. J. Appl. Phys., 39, 2414 (2000).
[13] D.L. Hibbard, S.P. Jung, C. Wang, D. Ullery, Y.S. Zhao, H.P. Lee, W. So, H. Liu. Appl. Phys. Lett., 83, 311 (2003).
[14] T. Arai, H. Sueyoshi, Y. Koide, M. Moriyama, M. Murakami. J. Appl. Phys., 89, 2826 (2001).
|